|
注:如需PDF原文,请将E-mail发送至本公司邮箱,注明所需文章即可。
张楷亮,宋志棠,张建新,檀柏梅,刘玉岭
摘要:针对超大规模集成电路多层互连结构中介质CMP 抛光速率低,急需的大粒径硅溶胶研磨料, 本文采用改进的粒径生长控制工艺制备介质CMP 用大粒径硅溶胶,并采用TEM、激光粒度分析仪和Zeta 电位测试仪等先进手段对其粒径大小、粒径分布和稳定性进行了表征。以低分散度硅溶胶纳米研磨料配制抛光浆料进行了二氧化硅介质的CM P 研究,结果表明,平均粒径103.4 nm 的硅溶胶浆料的去除速率达630 nm/min,有效解决了二氧化硅介质CM P 低速率的难题。
关键词:超大规模集成电路;化学机械抛光;纳米研磨料;硅溶胶;大粒径
随着IC 的飞速发展,特征尺寸纳米化,集成度高达数亿元器件/片,导致IC 结构立体化,布线多层化。特征尺寸的微细化迫使光刻精度要求越来越高,提高分辨率引起的焦深变浅难题使得材料表面的平坦化程度要求越来越高,多层互连结构中的每一层材料都要求平坦化,尤其是多层膜之间的介质层的平坦化。目前用于层间介质CM P 的研磨料多为分散法制备的大粒径二氧化硅研磨料(平均粒径> 130 nm)或小粒径硅溶胶研磨料,前者由于存在烧制阶段,二氧化硅颗粒较为聚集,不易分散,且表面形状较为尖锐,在CM P过程中容易造成表面划伤,粘度较大使得抛光后吸附性较强,不易清洗。但小粒径硅溶胶用于介质CM P 时抛光速率较低,无法满足CM P 的高效率要求,且由生长法制备大粒径硅溶胶研磨料粒径不易长大、且分散度大。
本文采用离子交换法,通过改进粒径生长控制工艺制备了低分散度、大粒径硅溶胶纳米研磨料,并对其粒径、分散度及稳定性进行了表征,以此研磨料配制抛光浆料进行了二氧化硅介质层的CM P 研究。
1 大粒径硅溶胶研磨料的制备及表征
1.1 大粒径硅溶胶研磨料的制备
首先以廉价的水玻璃为原料,通过阳离子交换法制备活性硅酸,再依次通过母液制备、粒径生长、陈化等改进的粒径生长控制工艺制备大粒径硅溶胶研磨料。
1.2 硅溶胶研磨料的测试与表征
硅溶胶研磨料用于CM P 时关键性能在于粒径大小、分散度及稳定性,为此本研究对制备的大粒径硅溶胶研磨料进行了如下测试和表征。
1.2.1 粒径分析
采用改进粒径生长控制工艺制备的大粒径硅溶胶研磨料透射电镜照片见图1 和图2,由图1可以看出,样品中硅溶胶颗粒为球形,且分散度较小,平均粒径约100 nm。为表征大粒径硅溶胶研磨料颗粒的生长结构,对其进行了高分辨TEM,如图2 所示。由于硅酸自聚合即可形成最小颗粒约2~3 nm 的胶粒,从图中可以看出,纳米研磨料表面并无小粒径胶体颗粒,所以本研究制备的大粒径硅溶胶纳米研磨料并非小颗粒硅溶胶胶粒的团聚体,而是通过Si-OH 间脱水形成化学键Si—O—Si 长大的。
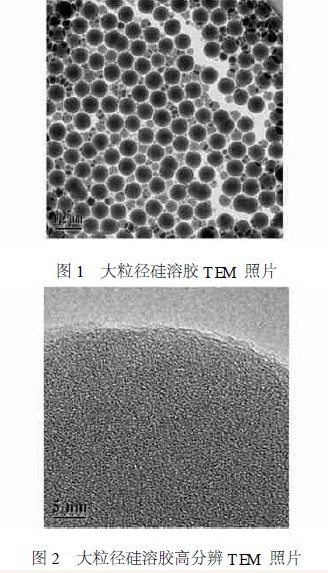
硅溶胶研磨料的粒径分布(分散度)是CMP浆料性能的一重要指标,本研究通过PCS对制备的大粒径硅溶胶粒径分布进行了测试,结果如图3 所示。由图3 可以看出,制得的硅溶胶研磨料数量平均粒径约100 nm,粒径分布较窄,即粒径分散度很小。分散度(Po lydispersit ion Index)一般由公式来计算衡量,[PDI]> 112 是多分散体系,而[PDI]为110~112 是为低分散体系,且[PDI]越小,分散度越小。测试结果表明:体积平均粒径103.5 nm,数量平均粒径103.4 nm,分散度[PDI]接近1,为低分散体系。


1.2.2 稳定性
关于溶胶类研磨料稳定性通常采用Zeta 电位来衡量,且认为胶体的稳定存放区域为< - 30 mV 或> 30 mV。本研究利用Zeta 电位仪对自制硅溶胶研磨料进行了稳定性表征,测试结果如图4 所示。由图可得本研究制备的硅溶胶研磨料的平均Zeta 电位为- 65 mV,表明自制的大粒径硅溶胶纳米研磨料稳定性较高。

1.2.3 其它性能指标
自制纳米硅溶胶研磨料的其它性能指标如表1 所示。由此可得,本研究已制备出分散度较低的、稳定的大粒径硅溶胶研磨料。

2 二氧化硅介质膜的CMP研究
硅溶胶研磨料用于CMP 时,划伤少、且易清洗,但由于粒径小、分散度大,所以在用于二氧化硅介质的CMP 时目前主要存在问题是抛光速率较低。由于二氧化硅介质的CMP 过程不存在氧化—还原等强化学反应,在CMP 时,抛光速率主要取决于机械方面的作用,研磨料的主要作用之一就是提供机械研磨,研究表明,通过增大研磨料粒径可以改善而二氧化硅介质的CMP 速率。但对于凝聚法制备的硅溶胶而言,粒径生长难度较大,目前粒径较小,抛光速率较低。本研究对三种不同粒径的硅溶胶研磨料进行CMP 比较,结果如图5 所示。随着粒径的增大,抛光速率显著提高,当研磨料采用粒径103.4 nm 的硅溶胶时,抛光速率可达630 nm/m in, 得到有效的改善,且抛光质量较高, 5 Lm ×5 Lm 范围内表面粗糙度RM S 小于2.5 nm。

本研究还对不同磨料浓度对抛光速率的影响进行了分析,结果如图6 所示。由图可得,对于粒径相同的条件下,随着研磨料浓度的增大,抛光速率相应增大。原因是研磨料浓度的增大,使得参与机械抛光的有效研磨料颗粒数量增多,抛光速率得到改善。但浓度越高,原料成本增大,综合考虑抛光效率及成本因素,本研究认为10% 左右的纳米研磨料浓度更适合二氧化硅介质膜的CMP。

3 结论
本研究采用离子交换法通过改进的粒径生长控制工艺制备出大粒径硅溶胶纳米研磨料,粒径可达100 nm,且分散度低,稳定性好。用于二氧化硅介质膜的CM P 时,抛光速率明显改善,可提高至630 nm/m in, 很好地解决了生长法制备硅溶胶研磨料用于二氧化硅介质CM P 时抛光速率低的问题。
|


